研究テーマ4の詳細: 窒化物半導体における励起子・キャリアダイナミクスに関する研究
2014年10月7日、3名の日本人博士がノーベル物理学賞を受賞したというニュースが、世界中を駆け巡りました。
その3名とは、名城大学の赤崎勇先生、名古屋大学の天野浩先生、カリフォルニア大学サンタバーバラ校の中村修二先生です。
受賞内容は、青色発光ダイオード(Light Emitting Diode: LED)の開発でした。
信号機やイルミネーションなど、我々は今や至るところで青色LEDを見かけることができます。最近良く見かける白色LED照明も、
実は、青色LEDがキーテクノロジーであることは御存知でしょうか?
白色LED照明は、蛍光灯に代わる次世代照明として、世界の照明に大きな変革をもたらそうとしています。
このように、世の中に普及するに至った(世界を変えた)青色LEDとその関連技術ですが、
"青色LEDはどんな材料で出来ているのか?"、"何で青色LEDは良く光るのか?"といった疑問に答えられる人はそうはいないと思います。
ここでは、青色LEDが"窒化物半導体"という材料で出来ていることを知ってもらい、
半導体光物性を評価することが如何に面白いかについて説明したいと思います。
※京都大学電気電子工学科3回生で光工学1を受講した学生は、配布資料[1]を傍に置くと一層理解が深まります
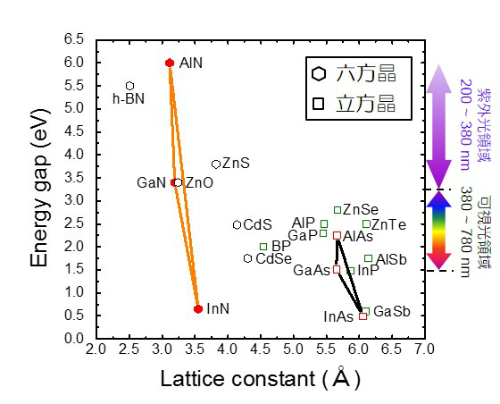
まず、上図を見てください。この図は、半導体の仕事に携わったならば、 必ず一度は見かける図です。横軸は格子定数(結晶格子の間隔)、 縦軸は禁制帯幅(すなわちバンドギャップ)で、図の中には半導体材料の名前が記されています。 京都大学電気電子工学科2回生配当の半導体の授業では、シリコン(Silicon: Si)という半導体材料について主に学びましたね. 上図から、世の中にはSiの他に、様々な格子定数とバンドギャップを持った半導体材料が存在することが分かります。
さて、Siの格子定数とバンドギャップを覚えているでしょうか?Siの格子定数とバンドギャップは、それぞれ5.43 Åと1.12 eVです。 上図のどの辺りに位置するか、一度確認してみてください。 おおよそ、砒化ガリウム(Gallium Arsenide: GaAs)の左下辺りですね。次は、1.12 eVの部分に、平行線を引いてみてください。 すると、上図右側に書かれている"可視光領域"からはみ出していることが分かると思います。 これは、Siにおいて、伝導帯底の電子と価電子帯頂上の正孔が再結合する際に、人間の眼に見える光を放出できない、ということを意味しています。 すなわち、Siを用いて、人間の眼に見えるLEDを作製することは通常※できません。 加えて、Siは間接遷移型半導体であるため、発光素子にあまり向いていないという問題点も存在します。
(※に関する補足)
先人達の叡智には素晴らしいものがあります。専門的になるのでここでは詳述しませんが、Siを用いて可視光発光を得る手段が実は存在します。
興味のある方は、ナノ結晶SiやポーラスSiなどをキーワードに調べてみてください。
では、どうすれば可視光で発光するLEDを作製することができるのか?
既に述べたように、Siでは可視光発光LEDを作製することは通常困難です。
そこで、研究者達は他の半導体材料で可視光発光LEDを実現しようと考えました。
ここで登場するのが、"窒化物半導体"という半導体材料です※。
窒化物半導体とは、窒化アルミニウム(Aluminum Nitride: AlN)、窒化ガリウム(Gallium Nitride: GaN)、
窒化インジウム(Indium Nitride: InN)という3つの半導体材料の総称で、(基本的に)全て直接遷移型半導体です。
※窒化物半導体の登場までには、複雑ないきさつがあります。詳しくは参考文献[1]を参照ください。
再び上図を見てください。GaNという半導体材料は、3.4 eVのバンドギャップを持っています。 例によって、3.4 eVの部分に、平行線を引いて見ましょう。すると、わずかながら"可視光領域"から外れていることが分かります。 Siで行った議論を再度展開すると、GaNを用いても可視光発光は得られないという結論になってしまいます。 しかしながら、ここからが半導体研究の醍醐味(の1つ)です。下記の2つの実験的事実が知られています。
・ある組み合わせの半導体同士は、混ぜることができる
・混ざった結晶(混晶と言います)は、混ぜた結晶の中間的な物性を(基本的に)有する
"ある組み合わせ"とは、例えば、上図の橙線や黒線で結ばれる材料群です。
窒化物半導体の場合、窒化アルミニウムガリウム(AlGaN)、窒化アルミニウムインジウム(AlInN)、窒化インジウムガリウム(InGaN)が
3元混晶として知られています。一方、"中間的な物性"となる物理量として、例えばバンドギャップが挙げられます。
これら文意を統合すると、
"InNとGaNの混晶であるInGaNは、III族元素(In, Ga)の組成比を制御することで、
バンドギャップをInNの値からGaNの値まで変調できる"、と言うことができます。
最後に、再び上図を見てください。
InNとGaNのバンドギャップは、可視光領域を縦断していることが分かります。
これは、組成比を制御することにより、"InGaNはあらゆる色で発光できる"ことを意味しています。
もうお分かりですね?InGaNを用いることで、青色LEDを作製することが可能です。現在、世の中に出回っている青色LEDの材料(発光層)は、
窒化物半導体の3元混晶であるInGaNです。
※AlInNもあらゆる色で発光できるのでは?と思った方、内容を理解してくれています。
ここまでは、青色LEDはInGaNという半導体材料の発光層を有している、という説明でした。以下では、 InGaNの性質を調べると、そこにはとても不思議な光物性の世界が広がっている、ということについて記します。"光物性"という言葉や歴史に関しては、 豊沢先生の寄稿に詳しく書かれています[2]。 さて、まずは下図を見てください。
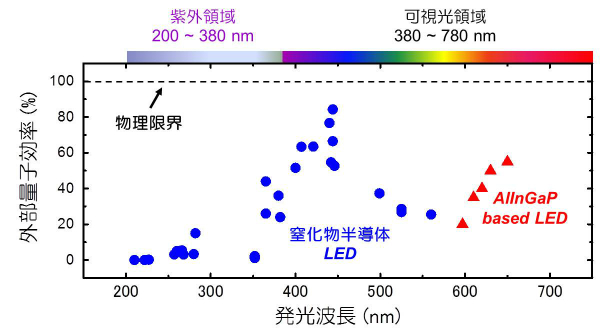
この図は、横軸がLEDの発光波長、縦軸がLEDの外部量子効率を示しています。 外部量子効率の詳細な定義は教科書を参照してもらうこととして、 簡単には、"LEDがどれだけ良く光るか"を示す指標だと思ってください。この図から、 青色LEDの外部量子効率は極めて高いことが分かりますね? 冒頭で述べたように、白色LED照明のキーテクノロジーは青色LEDです。 青色LEDの外部量子効率が高いことが、高効率白色LED照明の実現に繋がっています。
さて、"InGaNのとても不思議な光物性"とは、一体何のことでしょうか?それは、今述べたように、 InGaN青色LEDの外部量子効率がとても高いことです。すなわち、"InGaNは非常に良く光る"のです。 これだけでは、別に不思議なことには聞こえませんよね。不思議さを理解するためには、結晶について学ぶ必要があります。
結晶とは、"長距離秩序を持った格子と基本構造で規定される原子の集合"です。その秩序が一切乱れていない結晶は完全結晶と呼ばれます。 しかしながら、我々が住んでいる現実(有限温度)の世界には、完全結晶は存在しないことが知られています。つまり、秩序を乱す要因である"欠陥"が必ず存在します。 欠陥には、色々な種類があり、点欠陥、線欠陥、面欠陥、体積欠陥などがあります(欠陥はさらに細かく分類されており、 ここでは詳しく述べません)。
※結晶中の欠陥をゼロにはできないと述べましたが、減らすことは可能です。そして、その行為が重要です。半導体物理の真髄はその構造敏感性にあります。秩序を乱す少数の要因が、系全体の性質を支配し得ります。
さて、重要なことは、結晶中の欠陥はLEDの特性に悪事を働くということです。具体的には、LEDに電流を流したときに、 電気エネルギーがLEDに投入されるわけですが、欠陥はその電気エネルギーを熱エネルギーに変換してしまいます。 電気エネルギーを全て光エネルギーに変換するのが理想的なLEDですので、欠陥の存在はLEDの特性を悪化させるわけです。
では、具体的にInGaNに含まれている欠陥はどの程度存在するのでしょうか? InGaNに含まれている(線)欠陥の数は、AlInGaPという半導体材料に含まれている(線)欠陥の数の1万倍から10万倍程度とされています。 ここで、上図を見てください。AlInGaPを用いたLEDの外部量子効率も記されていますね? 欠陥の数が劇的に高いにも関らず、 InGaN青色LEDの外部量子効率は、AlInGaP赤色LEDの外部量子効率と同程度であることが分かります。 ここに、InGaNという半導体材料における光物性の不思議さがあります。
当研究室では、時間・空間分解分光技術を駆使することで、 この不思議なInGaNの光物性を解明しようと日夜研究に取り組んでいます。具体的には、何らかの手法でInGaNに電子を励起し、 その電子のダイナミクスを時間的・空間的に追いかけてやろう、というわけです。星の運動を理解したければ、天体望遠鏡で観察するが如くです。
星の場合と異なるのは、その時間的・空間的スケールです。星の場合を考えてみましょう。 地球の平均公転半径がおよそ1011 mですので、空間スケールとしてGm("G"はギガ、10の9乗)が1つ挙げられますね。 同様に、地球の公転周期は365日(31536000 s)なので、時間スケールとしてMs("M"はメガ、10の6乗)が1つ挙げられそうです。
一方、半導体中で励起された電子は、微小な距離だけ動いて一瞬で消滅してしまいます。 "微小な"や"一瞬で"など、定性的でとてもずるい表現ですね。一概には言えないのですが、電子の振る舞う舞台は、 空間に関してはnm("n"はナノ、10のマイナス9乗)スケールからμm("μ"はマイクロ、10のマイナス6乗)スケール、時間に関してはps("p"はピコ、10のマイナス12乗)スケールからμsスケール、と言うことができます。 つまり、星の運動と異なって、光物性の場合は、時間的・空間的に非常に細かく事象を知る必要があるのです。 当然、人間の眼でそのようなことはできません。
ここで登場するのが、ストリークカメラと近接場光学顕微鏡(SNOM)という装置です。 ストリークカメラは超高速光現象を観察できる装置で、psオーダの時間分解能を有しています。 SNOMはプローブ顕微鏡の一種で、光の回折限界を超えた空間分解能を有しています。SNOMに関する詳細は研究テーマ1(詳細)を見てください。
我々は、ストリークカメラを用いて、InGaNの光物性を評価しました。すると、 励起された電子は、消滅(再結合)する前に、ポテンシャルの底(極小)に向かって緩和していることが分かりました。 そこで我々は、電子のポテンシャルが凸凹になっており、電子はポテンシャルの凹の部分に移動・集中(局在)するのでは?と考えました。 そして、この局在現象によって電子は欠陥に捕まりにくくなり、InGaN青色LEDは高い効率を有する、とおよそ20年前に提案しました[3,4]。 これらの論文[3,4]は、1998年下半期の論文被引用件数で物理部門の世界4位になる等、大変な注目を集め、現在多くの研究者に支持されるモデルとなっています。
次いで我々は、SNOMを用いて、ポテンシャルが本当に凸凹になっているかどうか、ポテンシャルの凹の部分でInGaNは本当に良く光っているかどうか、 を実験的に直接観測することを目的としました。下図を見てください。下図はSNOMで測定したInGaNの発光強度マッピング像で、縦横軸は空間的な位置、 色は発光強度を表しています。 我々はSNOMを用いることにより、確かにInGaNの発光は空間的に分布しており、 ポテンシャルの凹の部分で強く青色発光していることを直接実験的に示しました[5,6]。

以上述べたように、"常識に反して青色LEDは良く光る"、 といったInGaNの不思議な光物性は、これまでの研究で解き明かされつつあると言えます(我々の研究室は少なからず貢献することができたと考えています)。 それでは、窒化物半導体の光物性は全て解明されたのか?というと、全くそのような事はありません。例えば、上から2番目の図を見直してみてください。 青色LEDの外部量子効率は確かに高いですが、発光波長が長波長化するにしたがってLEDの効率は低下していることが分かりますね? この理由に関して色々な説が提案されていますが、未だ統一見解は得られておらず、現在でも世界中で活発に議論されています。
また同様の図で、紫外LEDの効率が非常に低いことにも注目してください。ここまで触れてきませんでしたが、紫外LEDの発光層はInGaNではなく、 AlGaNという半導体材料が用いられています。紫外LEDの効率が低い理由に関しても様々な説が提唱されており、 窒化物半導体発光デバイスが抱える問題は山積みであると言えます。
このような問題を解決するためには、実験結果・理論計算結果の両観点から、窒化物半導体の光物性について深く考察し、 系を支配する物理が何であるかを見抜くことが不可欠です。そして、その物理を抽出する新規実験手法の構築・新規計算手法の確立が、 新規固体光現象の発見・解明に繋がると考えています。
関連論文 (論文のリンク先は学内から見ることができます)
[1] 「光工学1」、講義配布資料.
[2] 「光物性研究50年史のある断面--局在励起から励起子へ--」、豊沢豊先生著.
[3] Y. Narukawa, Y. Kawakami, M. Funato, Sz. Fujita, Sg. Fujita, and S. Nakamura.
Appl. Phys. Lett. 70, 981 (1997).
[4] Y. Narukawa, Y. Kawakami, Sz. Fujita, Sg. Fujita, and S. Nakamura.
Phys. Rev. B 55, R1938 (1997).
[5] A. Kaneta, K. Okamoto, Y. Kawakami, S. Fujita, G. Marutsuki, Y. Narukawa, and T. Mukai.
Appl. Phys. Lett. 81, 4353 (2002).
[6] A. Kaneta, M. Funato, and Y. Kawakami. Phys. Rev. B 78, 125317 (2008).